Ein Forschungsteam unter der Leitung von Professor Kim Jung-hwan und Professor Jung Chang-wook von der Graduate School of Semiconductor Materials and Devices Engineering am Ulsan National Institute of Science and Technology (UNIST) entdeckte einen entscheidenden Fehler in der weit verbreiteten Feldeffektmobilitätsmessung (FEM) in der Halbleiterforschung und -entwicklung: Aufgrund der Bauelementstruktur kann der Messwert um bis zu 30-fach verstärkt werden, was zu einer Überschätzung der Bauelementleistung führt. Das Team veröffentlichte standardisierte Designrichtlinien in der Fachzeitschrift ACS Nano, um Messfehler durch die Optimierung von Dünnschichttransistor-Strukturen (TFT) zu eliminieren und der Halbleiterindustrie eine zuverlässigere Bewertungsmethode bereitzustellen.
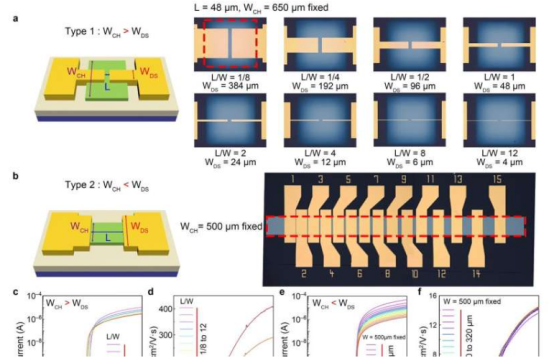
Als zentraler Parameter zur Messung der Ladungsträgermobilitätseffizienz von Halbleitern beeinflusst die FEM (Foot Electron Method) direkt die Chip-Betriebsgeschwindigkeit und den Stromverbrauch. Untersuchungen zeigen jedoch, dass die Geometrie von Oxid-TFTs Randströme induzieren kann: Ist die Kanalbreite größer als die Elektrodenbreite, fließt Strom durch den Randbereich außerhalb des Hauptkanals. Herkömmliche Messgeräte erfassen diesen Strom in ihrer Statistik, was zu einem künstlich erhöhten FEM-Wert führt. Durch Experimente und Simulationen hat das Team eine standardisierte Richtlinie vorgeschlagen: Die Kanalbreite sollte schmaler als die Elektrodenbreite sein oder das Verhältnis von Elektrodenbreite zu Bauteillänge (L/W) sollte ≤ 1/12 betragen. Dadurch lassen sich die Störungen durch Randströme minimieren und eine genaue FEM-Messung erzielen.
Um die Ergebnisse weiter zu validieren, schlug das Team die Kombination mit Hall-Mobilitätsmessungen vor – einem Indikator, der die inhärenten elektrischen Eigenschaften von Halbleitermaterialien direkt widerspiegelt, unabhängig von der Bauelementstruktur ist und zusätzliche, von geometrischen Fehlern unbeeinflusste Daten liefert. Professor Jin Zhenghuan betonte: „Messfehler können die Materialauswahl und den Vergleich von Bauelementen in die Irre führen und die technologische Weiterentwicklung in der Industrie behindern. Die Entwicklung global einheitlicher FEM-Bewertungsstandards ist ein entscheidender Schritt zur Förderung der Zuverlässigkeit der Halbleiterforschung.“
Weitere Informationen: Soohyun Kim et al., „Überschätzung der Mobilität in Dünnschichttransistoren: Die Auswirkungen der Gerätegeometrie und des Randstroms“, ACS Nano (2025). Zeitschrifteninformationen: ACS Nano
